機器利用可能 本部
本部
マスクレス露光装置
最終更新日2025年10月1日
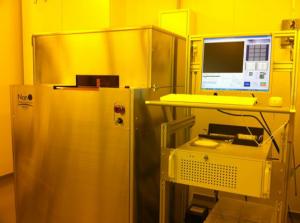
マスクレス露光装置の外観
- 用途
フォトリソグラフィによるレジストの微細パターニング(フォトマスク、微細電極、マイクロ流路、マイクロレンズ等の試作・加工)
- 仕様
露光方式:DMDを用いた反射投影露光(ステップ式によるショット繋ぎ合わせ)
最大描画面積:100mm×100mm
最小画素:1μm×1μm
露光画素数:1024×768ピクセル(XGA)
1ショットの露光範囲:1.024mm×0.768mm
光源:波長405nm LED(※単波長)
オートフォーカス範囲:±200μm
試料寸法:最大φ4インチ、または□100mm以下、厚さ4mm以下
データ形式:DXFまたはGDS 2 CADデータを読み込んで直描が可能
機器概要
- 分類
- N:半導体製造・MEMS加工
- 担当部署
- 電気技術グループ
- 導入年度
- 2011
- 型番
- DL-1000GS/TS
- 製造者
- 株式会社ナノシステムソリューソンズ
- 備考
・CAD で設計したパターンを基板に直接投影できる露光装置です。
・フォトマスクが不要なため、 研究開発や少量小面積試作においてスループットが向上します。
・重ね合わせ露光(X,Y,θアライメント)、グレースケール露光機能(露光量を256階調でパターニング)も利用可能です。
・設備はクリーンルームにあります。【加工事例】
(参考)レジスト加工事例[PDF]【MEMS関連設備】
以下のウェブページに記載の関連設備をご参照ください。
/research/field/mems/
料金表
| 設備利用 | 試験項目 | 項目コード | 適用料金(税込) | |
|---|---|---|---|---|
| 中小 | 一般 | |||
| 機器利用 | (9)マスクレス露光装置 [1時間につき] | S91911 | 2,450円 | 5,120円 |
| 機器利用 | (1)機器利用指導 [30分につき] | M11 | 1,130円 | 2,260円 |
| 機器利用 | (1)機器利用準備 [30分につき] | M12 | 1,130円 | 2,260円 |