機器利用可能 本部
本部
高速ディープエッチング装置
最終更新日2026年3月29日
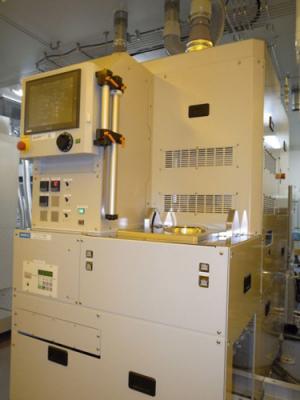
高速ディープエッチング装置の外観
- 用途
シリコンのエッチング:トレンチ(溝)形成や貫通加工可能 耐プラズマ試験
- 仕様
放電形式:誘導結合方式(Inductively Coupled Plasma:ICP)
チャンバー温度範囲:25℃ から 80℃ まで
最大基板寸法:直径4インチ(直径100mm)静電吸着式
試料交換方式:ロードロック
高周波電源:13.56MHz ICP 1kW、BIAS 200W(装置最大300W)
ガス種と流量(Max):
SF6 500sccm
C4F8 500sccm
CF4 100sccm
CHF3 100sccm
Ar 500sccm
O2 500sccm
C4F8デポ、SF6エッチングの高速切替可能
チャンバー圧力:2.0Paから15.0Pa
到達真空度:5.0×10-3Pa(反応室)
機器概要
- 分類
- N:半導体製造・MEMS加工
- 担当部署
- 固体デバイス技術グループ
- 導入年度
- 2011
- 型番
- RIE-400iPBT
- 製造者
- サムコ株式会社
- 備考
設備はクリーンルーム内にあります。
小片試料および貫通加工の場合には直径4インチダミーウエハへの貼り付け加工処理が必要です。【依頼試験について】
一部試験条件によっては対応できない場合があります。
一日の試験連続時間は最長8時間とし、8時間以上の場合は8時間以降は翌日とさせていただきます。
原則として、試験開始(試験品投入)時、及び試験終了(試験品取り出し)時には、御来所いただきます。【MEMS関連設備】
以下のウェブページに記載の関連設備をご参照ください。
/research/field/mems/
料金表
| 設備利用 | 試験項目 | 項目コード | 適用料金(税込) | |
|---|---|---|---|---|
| 中小 | 一般 | |||
| 機器利用 | (6)ドライエッチング装置 高速ディープエッチング装置※ライセンス制度対象機器 [1時間につき] | S91611 | 3,840円 | 7,090円 |
| 依頼試験 | (5)性能試験 耐プラズマ試験 ICP型 [1時間につき] | T315521 | 12,090円 | 24,180円 |
| 依頼試験 | (5)性能試験 耐プラズマ試験 ICP型(同一試験の追加) [1時間につき] | T315522 | 3,300円 | 6,600円 |