集束イオンビーム(FIB)-走査電子顕微鏡(SEM)複合装置
公開日:2026年3月2日 最終更新日:2026年3月2日
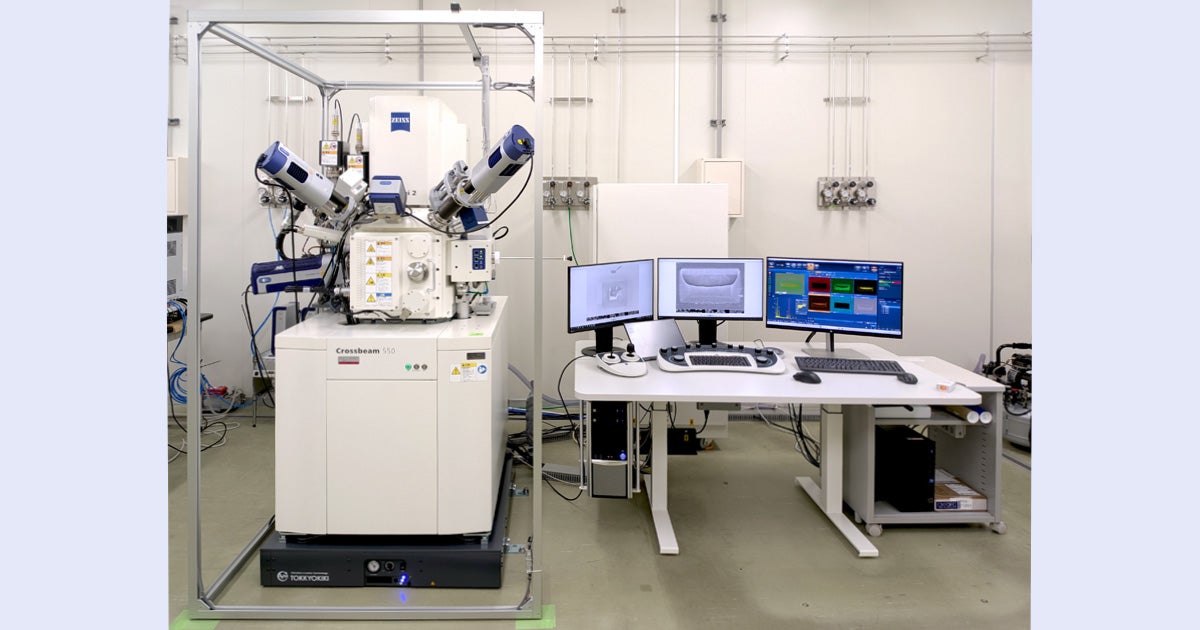
東京都立産業技術研究センター(以下、都産技研)では、ガリウムをイオン源とする集束イオンビーム(Focused Ion Beam、以下FIB)と、電界放出型走査電子顕微鏡(Field Emission Scanning Electron Microscope、以下FE-SEM)とを備えたFIB-SEM複合装置を新たに導入し、2025年12月より依頼試験を開始しました。
- FIBにより、数十μm以下の微小な領域の断面加工が可能で、作製した断面をFE-SEMで観察することができます。
- 試料を磁場にさらさないタイプのFE-SEMであるため、磁性体でも高分解能で観察可能です。
- エネルギー分散型X線分析や、透過電子顕微鏡の観察試料作製など、さまざまな支援が可能です。
概要
材料の研究・開発や製品の不良要因調査などにおいて、数十μm以下の微小な領域の観察が必要な場合がよくあります。不良要因調査などでは、最初に表面の観察を行い、さらに表面からは判断できない要因を探るために内部の断面観察まで必要となることも少なくありません。しかしながら、一般的にこのような微小領域に対しては、機械加工による断面作製は非常に困難です。
FIBを試料表面に照射・走査すると、イオンビームによる原子レベルのスパッタリング現象により、試料に機械的なストレスを与えずに加工ができます。FIBをFE-SEMと組み合わせたFIB-SEM複合装置では、FIBで作製した断面をFE-SEMで観察することができます。加えて、ガスノズルから原料ガスを吹き付けると、イオンビームの照射領域だけに炭素、タングステン、白金などを局所的に堆積(デポジション膜)させることができます。デポジション機能は試料表面の保護や配線の接続などに活用可能です。
装置の特徴
この装置に備えられているFE-SEMは試料を磁場にさらさないタイプであり、磁性体でも高分解能観察が可能です。デポジションは炭素、タングステン、白金が可能です。FIBとSEMの角度は54度です(図1(a)) 。断面に直交する方向からSEM観察するには対象の領域を薄片として取り出す必要があり(図1(b))、そのための金属プローブ(細い金属の針)を備えています。
.jpg)
活用事例(1) 層構造の断面加工・観察・面分析
我々の身の回りで使われる製品には、基材と異なる層構造を表面に持つものが数多くあります。層構造をFIBで断面加工した後、SEMで観察し、さらにエネルギー分散型X線分析(Energy Dispersive X-ray Spectroscopy、EDS) 装置で定性分析することで、各層の形状・厚さを直接評価することができます。
一例として、鉄板に亜鉛めっきをし、さらにクロメート処理(腐食を防ぐための表面処理)をした試料に炭素をコーティングしてから、FIB-SEM複合装置内に導入しました。タングステンを主成分とする保護層を堆積させてからFIBで断面加工し、FE-SEMにより観察しました。さらに、視野の各点でEDS分析することで、元素マッピングを実施し、各層の形状・厚みを直接評価しました (図2)。
.jpg)
活用事例(2) 透過電子顕微鏡観察用の試料作製
FE-SEMによる試料の表面・断面構造観察に加えて、透過電子顕微鏡(TEM)で試料の内部構造を観察したい場合、FIB-SEM複合装置でTEM観察用の薄片試料を作製することが可能です。
具体的にはまず、TEMで観察したい領域の上に保護層を形成し、さらに周囲をFIBで取り除きます。つぎに、観察対象を含む領域と金属プローブをデポジションで接着します。そして、FIBで下部を取り除くと、TEM観察したい領域を含む薄片試料を基材からサンプリングすることができます(図3(a - g))。
これを図3(h)のように、TEM観察用のメッシュにデポジションで接着してから、FIBで薄片とプローブとを切り離します。薄片の両面をFIB加工で電子線が透過する厚さまで薄くすることで、TEMで観察できるようになります。図3(i)は、シリコンウェハーから薄片を作製し、シリコン原子のダンベル構造をTEMで観察した事例となります。
.jpg)
用語説明
スパッタリング現象
高エネルギーのイオンが試料表面に衝突することで、表面の原子がはじき出される現象。FIB では、この仕組みを利用して材料を原子レベルで削る(加工する) ことができます。
エネルギー分散型X線分析
電子ビームによって励起された、元素ごとに固有のエネルギーを持つ特性X線を検出することによる定性分析
関連情報
仕様および利用料金については下記設備ページをご覧ください。
同じカテゴリの記事

