透過電子顕微鏡
公開日:2021年8月15日 最終更新日:2025年3月21日

- 試料中を透過した電子を結像して拡大像を作成
- 試料の微細組織や幾何学的構造の観察が可能
- エネルギー分散型X線分光器による局所元素分析が可能
動画で見る、透過電子顕微鏡
装置の特徴
透過電子顕微鏡(TEM)法では、電子線(平行ビーム)を試料に照射し、試料中を透過した電子を電磁レンズで結像し、高倍率で観察します。特に高分解能TEM法では、試料中を透過した電子と回折を起こした電子の両方を使って結像することで、格子像の観察が可能です。
走査透過電子顕微鏡(STEM)法では、細く絞った電子線束を試料に走査しながら照射し、試料中を透過した電子線強度を輝度変調して像を得ます。試料中の構成元素によるコントラストを作ることができます(Zコントラスト)。
TEM、STEMとも、エネルギー分散型X線分光器(EDX)による元素分析が可能です。電子線を照射するとそこに含まれる元素特有のX線が出てきます。これを分光することで含まれている元素がわかります。STEMではスポットでの分析やライン・マッピング分析も可能となります。
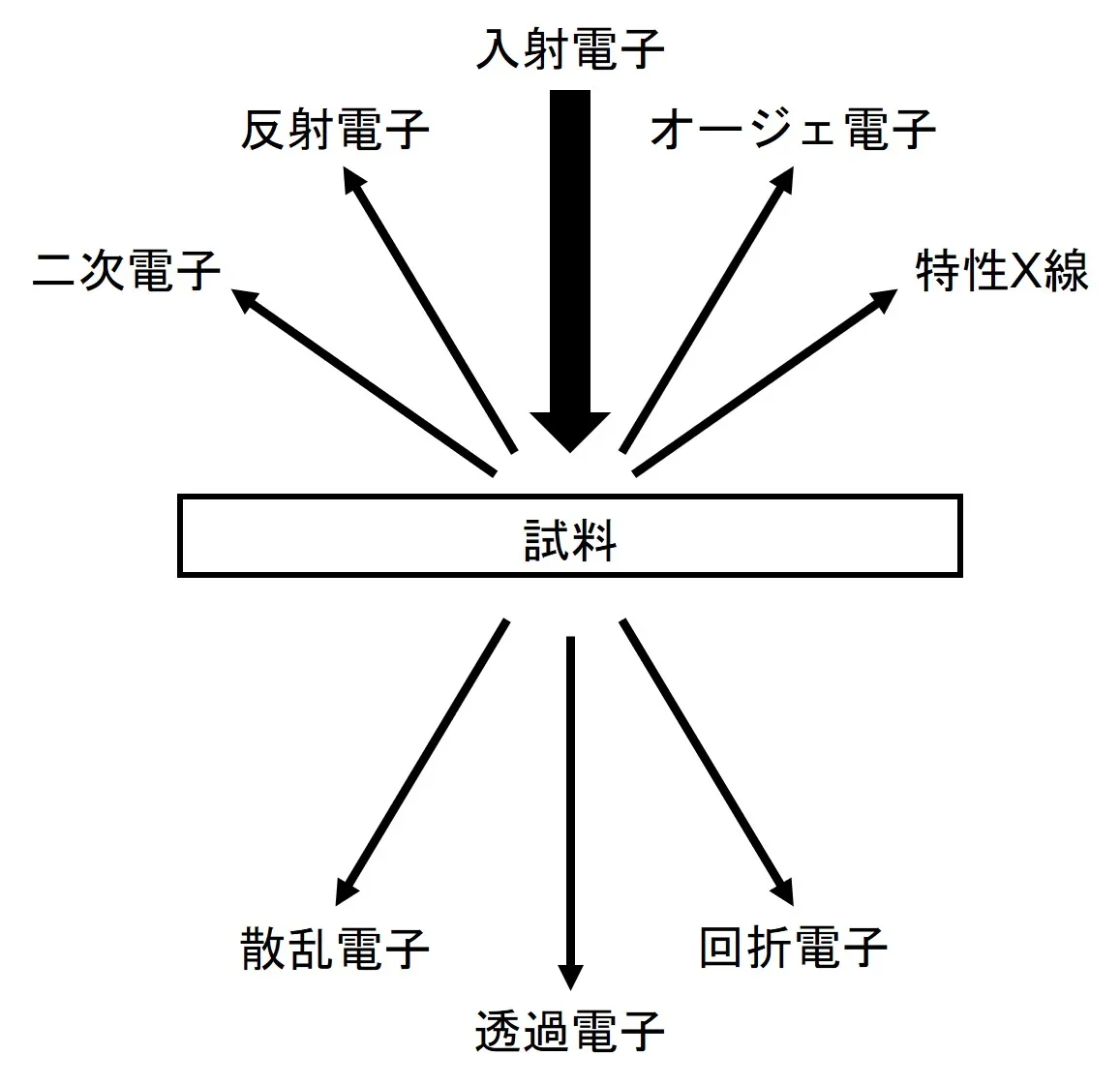
活用事例
ナノ物質(サイズが100 nm以下の物質)の観察・撮影・元素分析が可能です。ナノ粒子の形状・粒径分布やナノワイヤーの太さなどを直接観察したり、それらを構成する元素を定性分析したりすることができます。
また、高分解能TEM像では、例えば薄膜中の欠陥を観察し、膜の特性を考察することができます。TEM法で撮影した画像の例を図2に示します。高移動度を示す酸化スズ系透明導電膜を断面加工・観察し、面欠陥の成長が膜中で止まっていることがわかりました。このことから、高移動度を示す理由を考察しました(文献1)。
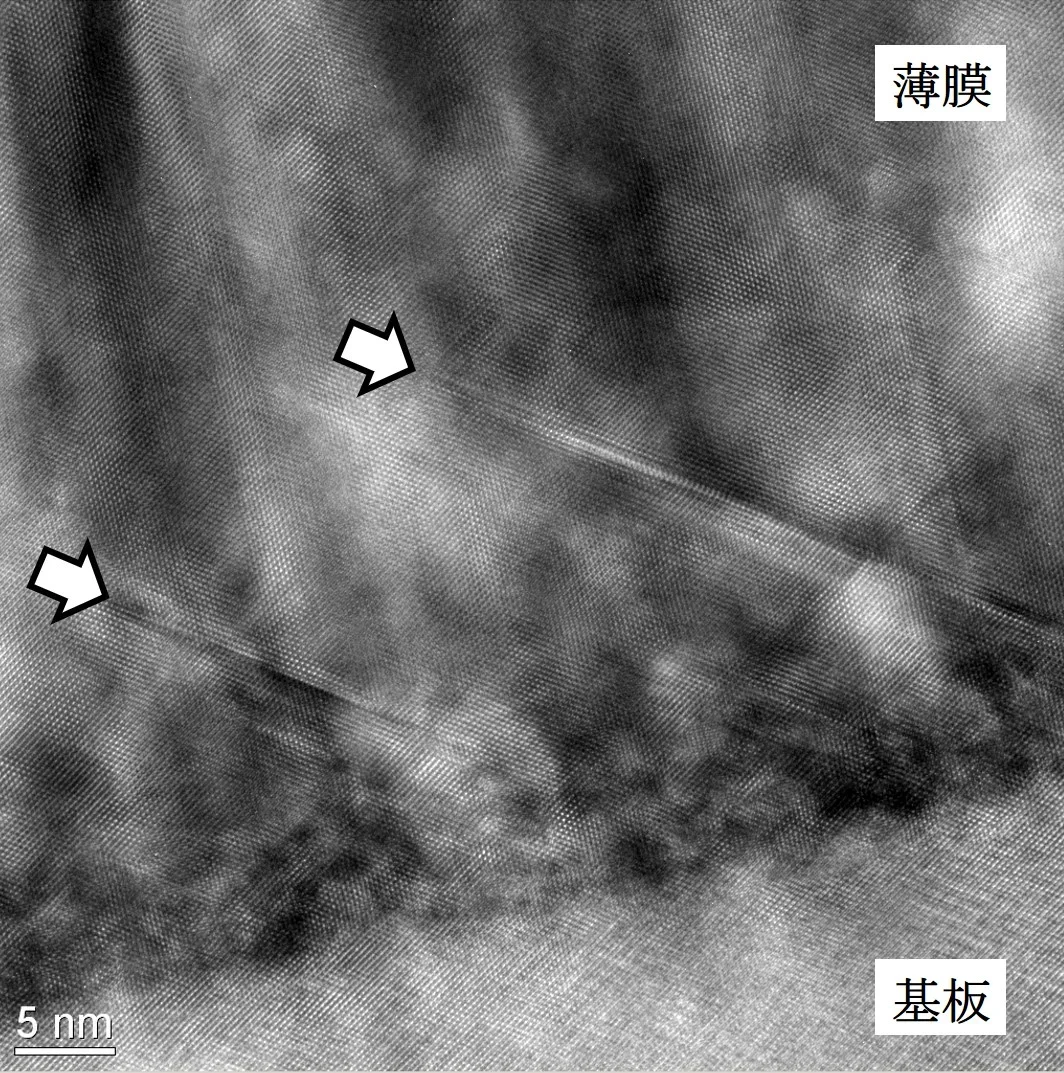
図3は、異種金属接合界面の断面をHAADF-STEM法で観察・分析した結果です。
これら接合界面では、接合時に付与されるエネルギーにより反応相が形成されます。EDXにより、接合界面の状態を観察するとともに、含まれる6元素の分布を可視化できます。
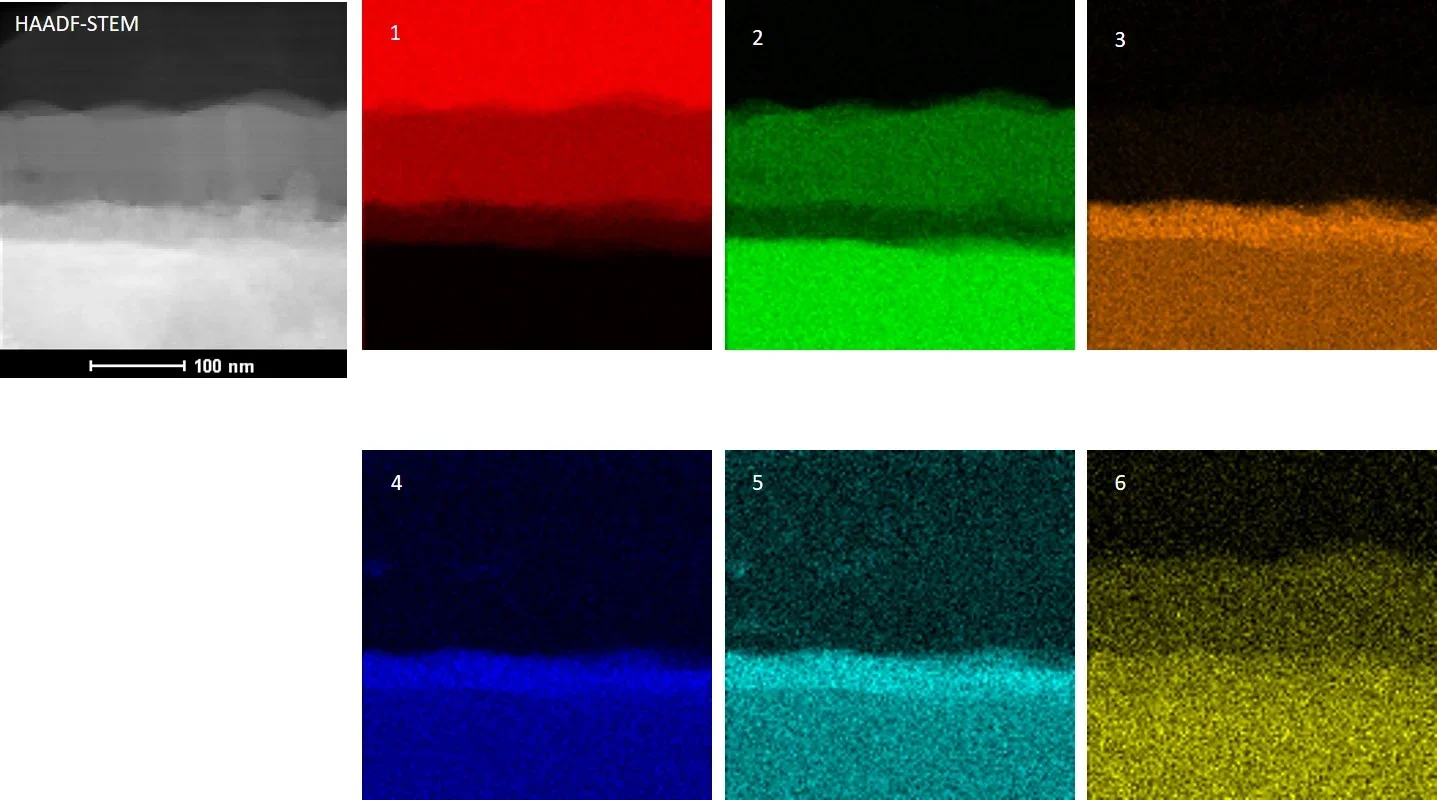
透過電子顕微鏡を使った分析のご相談は、計測分析技術グループまでお問い合わせください。
仕様および利用料金
仕様および利用料金については設備ページをご覧ください。
同じカテゴリの記事