集束イオンビーム(FIB) - 走査電子顕微鏡(SEM)複合装置
最終更新日2025年12月18日
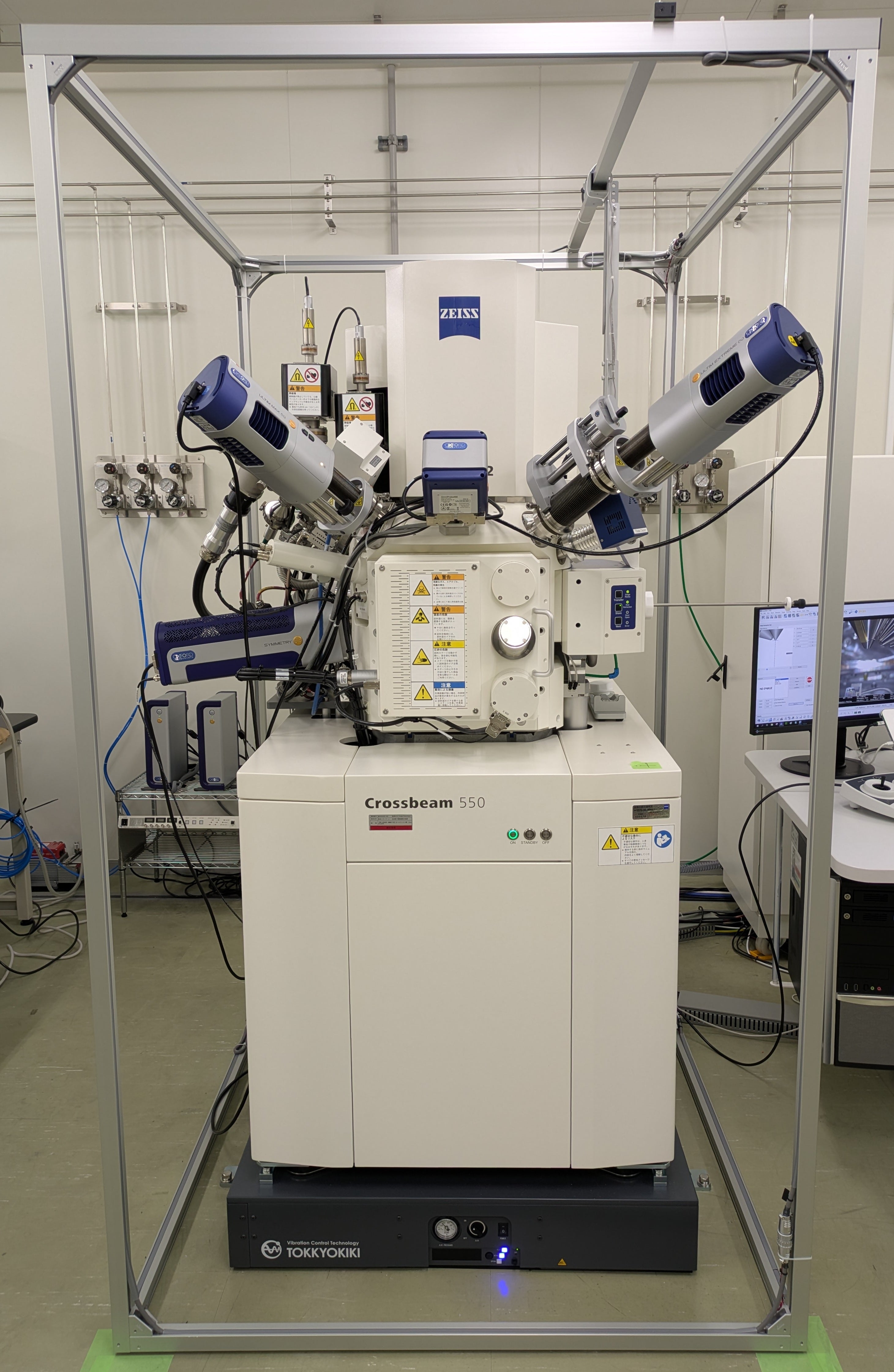
集束イオンビーム - 走査電子顕微鏡(FIB-SEM)複合装置の外観
用途
FIBによる表面・断面加工
SEMによる像観察・写真撮影
デポジション(炭素、白金、タングステン)
エネルギー分散型X線分光(EDS)測定
電子後方散乱回折(EBSD)測定
仕様
FIB: ガリウムイオン銃
SEM: ショットキー電界放出電子銃
EDS(1): Ultim Max Infinity 170
検出元素 4Be~98Cf
EDS(2): Ultim Extreme Infinity
検出元素 3Li~83Bi
EBSD: Symmetry S3
(EDS、EBSDはともにオックスフォード・インストゥルメンツ株式会社製)
試料サイズ: 直径100 mmまで、高さ30 mmまで
※加工・観察・分析可能な箇所・範囲は試料形状に応じて異なります。
機器概要
- 分類
- C:顕微鏡:走査電子顕微鏡
- 担当部署
- 計測分析技術グループ
- 導入年度
- 2025
- 型番
- Crossbeam 550
- 製造者
- カールツァイス株式会社
- 対応試験規格
- 備考
料金表
| 設備利用 | 試験項目 | 項目コード | 適用料金(税込) | |
|---|---|---|---|---|
| 中小 | 一般 | |||
| 依頼試験 | (20)走査電子顕微鏡によるもの 像の観察 [1試料につき] | T632111 | 12,460円 | 18,100円 |
| 依頼試験 | (20)走査電子顕微鏡によるもの 写真撮影 [1撮影につき] | T632121 | 2,890円 | 4,410円 |
| 依頼試験 | (20)走査電子顕微鏡によるもの 定性分析 エネルギー分散型分光器によるもの [1測定点につき] | T632211 | 9,100円 | 13,610円 |
| 依頼試験 | (20)走査電子顕微鏡によるもの 線分析又は面分析 エネルギー分散型分光器によるもの [1測定につき] | T632311 | 14,960円 | 26,000円 |
| 依頼試験 | (20)走査電子顕微鏡によるもの 試料作製 集束イオンビームによる断面加工 [1箇所1時間につき] | T63241S | 15,970円 | 31,950円 |
| 依頼試験 | (20)走査電子顕微鏡によるもの 試料作製 集束イオンビームによる断面加工(同一箇所の追加) [1時間につき] | T63242S | 9,680円 | 19,370円 |
| 依頼試験 | (21)透過電子顕微鏡によるもの 試料作製 集束イオンビームによる薄片試料の作製 [1箇所1時間につき] | T63342S | 28,290円 | 48,660円 |
| 依頼試験 | (21)透過電子顕微鏡によるもの 試料作製 集束イオンビームによる薄片試料の作製(同一箇所の追加) [1時間につき] | T63343S | 13,580円 | 27,160円 |
